
환경 측정 니즈에 대응 (광학계의 대기 중 배치 / 연속 가열・냉각 지원)
- 자동화를 통한 생산성 향상을 추구
- Operator로부터 기인된 측정 오차의 배제를 추구

4인치 전동 Stage

Cantilever 자동 교환
신뢰성
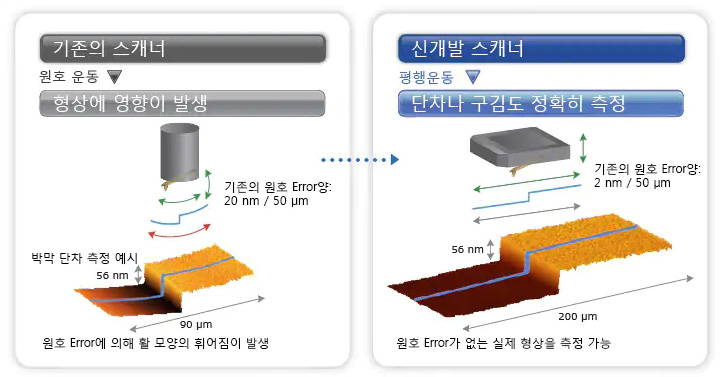
관찰 시료: 실리콘 기판 상의 Amorphous Silicon 박막
* 광역 Flat Scan Mechanical로 측정 오차 배제를 추구
기존의 SPM에 사용되어 왔던 Tube형 Piezo 스캐너는 원호 운동에 의해 휘어진 데이터에 소프트웨어적 보정을 걸어 평골화 처리를 실시해 왔습니다.
그러나 이 보정으로도 원호 운동의 영향을 완전히 제거할 수는 없으므로 Data에 왜곡이 남는 경우가 있었습니다.
AFM5500M은 새롭게 개발한 Flat 스캐너를 탑재하여 원호 운동의 영향을 받지 않는 정확한 측정을 실현했습니다.

관찰 시료: 다이요 전지 Texture 구조 (결정 방위에 의한 좌우대칭 입체 구조)
* AFM5100N (Open Roof 제어) 사용 시
* 높은 수직성
기존 SPM에 사용해 왔던 스캐너는 수직 방향의 신축 동작을 행할 때 휘어짐(Cross Toque)이 발생하였습니다. 이는 양 쪽 형상의 차이나 영상이 왜곡되는 원인이었습니다.
AFM5500M에서는 수직 방향에 Cross Toque가 없는 스캐너를 새롭게 개발・탑재하여 좌우 왜곡이 없는 정확한 측정을 실현하였습니다.
친화성
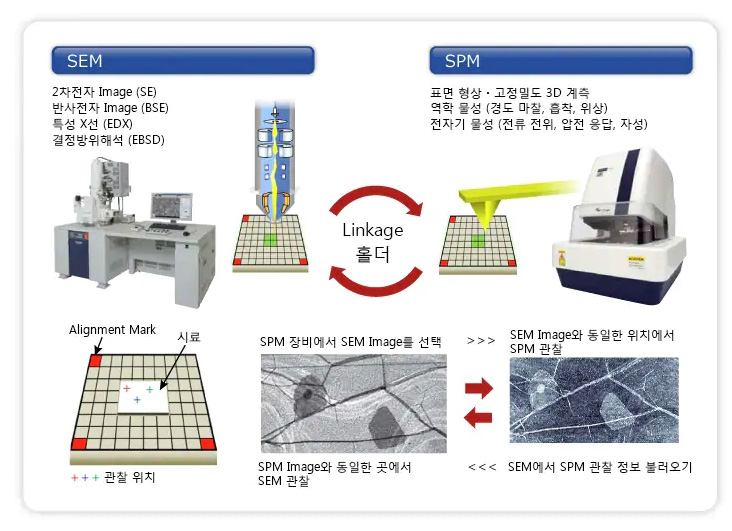
다른 검사 분석 수단과의 친화성을 추구
SEM-SPM에 공통 좌표 Linkage 홀더가 있어 동일 시야의 형상, 구조, 조성, 물성을 빠르고 간단하게 관찰, 분석할 수 있도록 하였습니다.
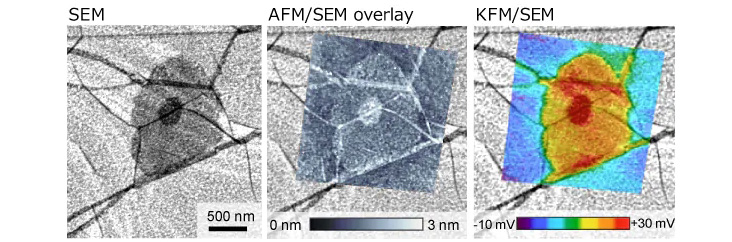
SEM-SPM 동일 시야 관찰 예시 (시료: Graphene/SiO2)
SEM과 SPM Image Overlay: ㈜아스트론사의 어플리케이션 AZblend Ver2.1. 사용
KFM (Kelvin Probe Force 현미경)을 통한 형상 Image (AFM Imager)와 전위 Image (KFM Image) 를 SEM Image에 Overlay시킨 데이터입니다.
- SEM의 Contrast 차를 보면 AFM Image의 Graphene 1층만큼의 높이에 상당한다는 것을 알 수 있습니다.
- Graphene의 층 수 등에 의해 표면 전위 (일함수)가 다르다는 것을 알 수 있습니다.
- SEM Contrast의 기원을 SPM에 의한 고정밀도 3D 형상 계측과 물성 관찰을 통하여 더욱 심도 있게 추구할 수 있습니다.
앞으로도 타 현미경 및 검사 장비와의 Linkage를 강화해 나가겠습니다.
AFM5500M 유닛
| Stage |
정밀전동Stage 관찰 가능 영역: 100 mm (4인치) 전역 stroke: XY ±50 mm, Z ≥21 mm 최소 Stage: XY 2 µm, Z 0.04 µm |
BOW* | 2 nm / 50 µm이하 |
|---|---|---|---|
| 최대 시료 사이즈 |
직경: 100 mm (4인치상당), 두께: 20 mm 시료 하중: 2 kg |
검출계 | 광 레버 방식 (Low Coherent 광학계) |
| 주사범위 | 200 µm × 200 µm × 15 µm (XY: Closed loop 제어 / Z:변위 센서 계측) | 직상광학현미경 |
Zoom 배율: ×1 ~ ×7 시야범위: 910 µm × 650 µm ~ 130 µm × 90 µm 모니터 배율: ×465 ~ ×3,255 (27인치 모니터) |
| RMS Noise Level* | 0.04 nm이하 (고분해능 모드) | 제진대 | 탁상 Active 제진대 500 mm(W) × 600 mm(D) × 84 mm(H), 약 28 kg |
| 반복 재현성* | XY: ≤15 nm(3σ, 10 µm pitch계측) / Z: ≤1 nm (3σ, 100 nm 깊이 계측) | 방음Box | 750 mm(W) × 877 mm(D) × 1400 mm(H), 약 237 kg |
| XY 직교도 | ±0.5° | 크기 및 중량 | 400 mm(W) × 526 mm(D) × 550 mm(H), 약 90 kg |
* 사양 수치는 시스템 구성 및 설치 환경에 따라 달라질 수 있습니다.
AFM5500M 전용 Probe Station
| OS | Windows7 | 분석 Software | 3차원 표시 기능, 표면 거칠기 분석, 단면 분석, 평균 단면 분석 |
|---|---|---|---|
| RealTune® II | Cantilever진폭, 접촉력, 주사속도 및 Feedback Gain 자동 조정 | 装置制御機構 | カンチレバー自動交換、自動光軸調節 |
| 조작화면 | 내비게이션 기능, Multi Layer 표시기능(측정/해석), 3D Overlay 기능, 스캔 가동범위/측정 이력 표시 기능, 데이터 해석 일괄 처리 기능, 탐침 평가 기능 | 크기 및 중량 | 340 mm(W) × 503 mm(D) × 550 mm(H), 약 34 kg |
| X, Y, Z주사 전압 | 0~150 V | 전원 | AC100 ~ 240 V ±10% 단상 |
| 동시측정 (Data Point) |
4화면 (최대 2,048 × 2,048) 2화면 (최대 4,096 × 4,096) |
측정모드 |
표준: AFM, DFM, PM(위상), FFM 옵션: SIS형상, SIS물성, LM-FFM, VE-AFM, Adhesion, Current, Pico-Current, SSRM, PRM, KFM, EFM(AC), EFM(DC), MFM |
| 스캔 화면 비율 | 2:1, 4:1, 8:1, 16:1, 32:1, 64:1, 128:1, 256:1, 512:1, 1,024:1 |
옵션: SEM-SPM Linkage System
| 히타치 하이테크 SEM 대응기종 |
SU8240, SU8230 (H36 mm타입), SU8220 (H29 mm타입) | 최대 시료 사이즈 | Φ20 mm × 7 mm |
|---|---|---|---|
| 시료 홀더 사이즈 | 41 mm(W) × 28 mm(D) × 16 mm(H) | Alignment 정밀도 | ±10 µm (SPM Alignment 정밀도) |


